转移印刷是一种广泛应用于柔性电子和低维物理领域的器件加工及异质结构筑手段。与传统微纳加工技术相比,转移印刷技术可以放宽器件加工的条件限制,能够在与常规制造工艺不兼容的柔性或脆弱基底上制造器件。然而,传统的转移印刷过程通常需要在母基底上添加牺牲层,以使器件组分可转移,而牺牲层的去除过程往往会对器件界面造成损伤。因此,开发一种无需牺牲层的转移印刷方法对于提高器件质量和简化制造工艺具有重要意义。
金属电极和原子层沉积(ALD)介电层是制造顶栅晶体管的两个重要组成部分。因此,成功转移印刷的前提是能够同时从母基底上转移和剥离金属电极与ALD介电层。目前,经过科学家的努力,已可实现金属电极的无牺牲层转移。然而,作为现代电子工业中不可或缺的关键电子材料, ALD介电层(如Al2O3和HfO2)的晶圆级无牺牲层转移及无损器件集成,仍具挑战。
二、文章简介:
研究团队选择商用云母作为预沉积基底,关键在于其类石墨烯的原子级平整表面和独特的非中性层状结构,使其兼容ALD直接生长(不同于石墨烯等惰性表面)。高分辨透射电镜(TEM)直接观测到ALD氧化物(Al₂O₃, HfO₂)与云母之间存在约0.5 nm的范德华(vdW)间隙(图1),显著削弱了界面粘附力。实验证明,云母的超亲水性使得水分子能轻易嵌入该vdW间隙,导致ALD氧化物图案在短时间水浸泡后即可轻松剥离,而在传统SiO₂/Si基底上则牢固附着。这种弱界面相互作用源于ALD循环水脉冲处理诱导的水汽嵌入效应。
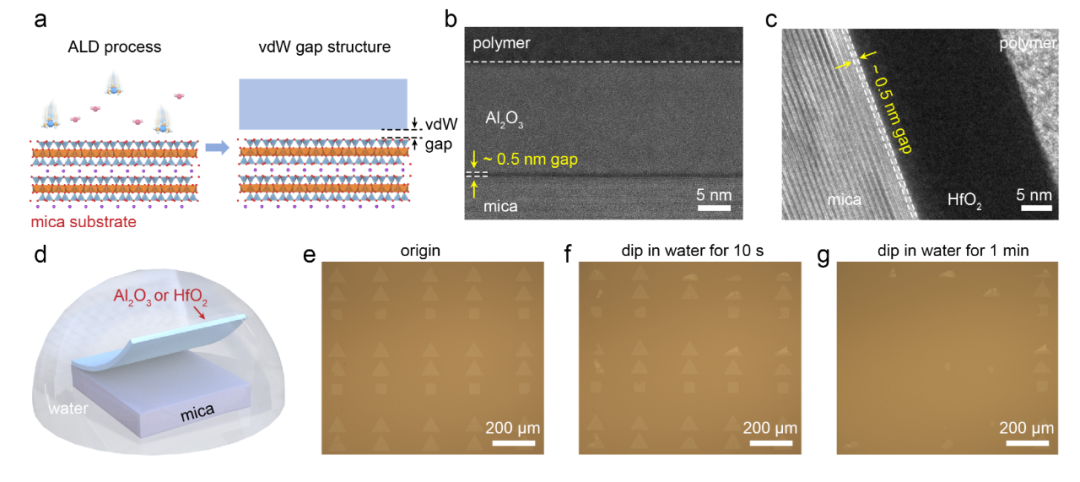
图1. 云母衬底与ALD栅介质之间的弱界面相互作用。
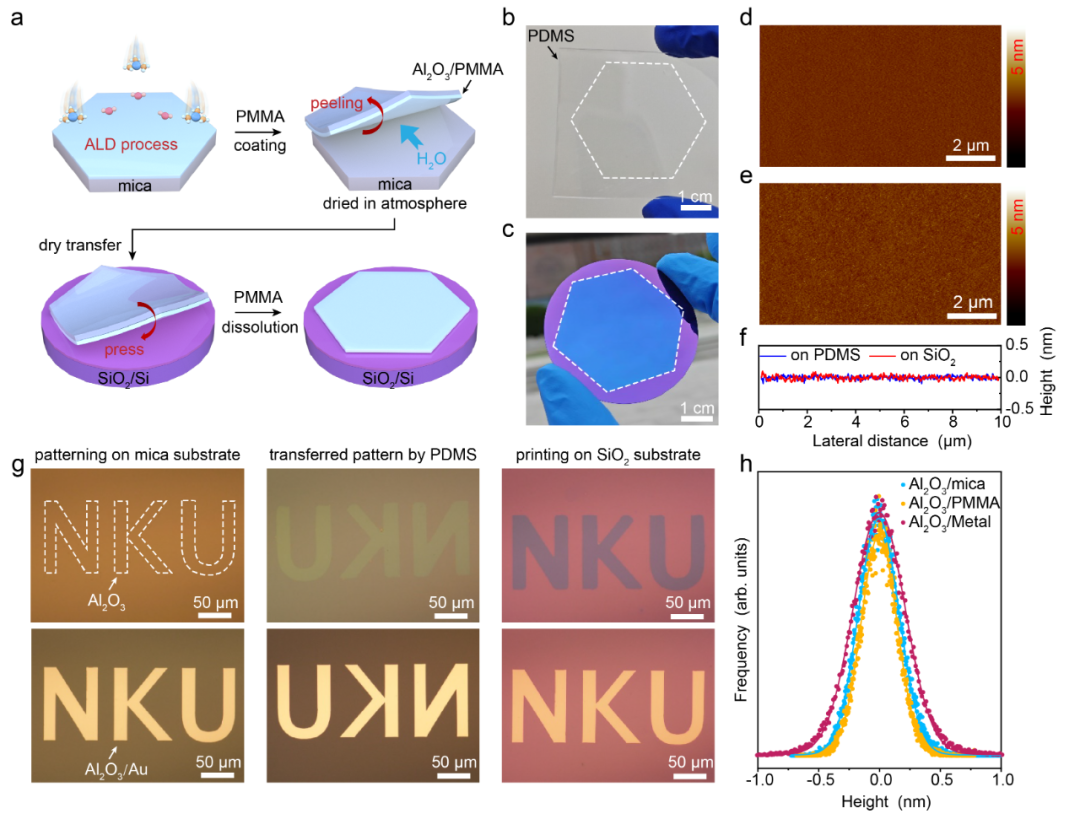
图2. 晶圆级ALD栅介质及高κ金属栅的无损转移。
该技术的核心突破在于能够一次性转移整个顶栅器件堆叠(包含源漏电极、ALD介电层和顶栅电极)(图3)。剥离的堆叠表面同样原子级平整、洁净(Ra ~ -0.15 nm,),并可通过范德华集成方法,与MoS2形成了具有完美、无损伤界面的异质结器件。这种一步集成方式完全避免了传统光刻、真空沉积和ALD工艺对脆弱二维材料的物理化学损伤。
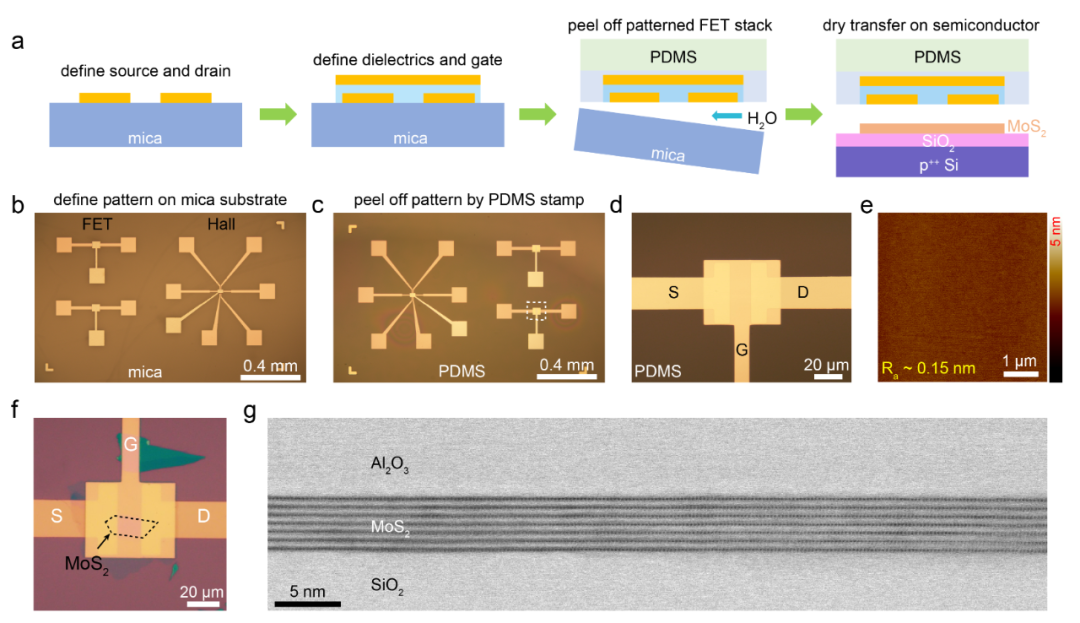
图3. 全器件堆叠一体化转移。
通过这种一步法集成器件的手段,团队制备了一种全栅控MoS2晶体管器件,由于可以有效控制整个沟道的耗尽区域,全覆盖晶体管比部分栅控MoS2晶体管表现出更高的开态电流和载流子迁移率,尤其对于本征不导电的增强型的二维半导体材料,全栅控的器件结构才能有效开启沟道,实现逻辑运算。得益于干净平整的异质界面,制备的MoS2器件均表现出可忽略的栅极回滞(~5 mV)和DIBL效应(~3.5 mV/V),同时拥有接近热发射极限的亚阈值摆幅(~63 mV/dec)。

图4. 高性能无回滞MoS2场效应晶体管器件的构筑。
该技术的另一重要应用是成功制备了全封装结构的顶栅霍尔器件(图5)。以对空气极其敏感的少层黑磷(BP) 为例,该器件即使在空气中暴露一个月后,仍能保持优异的欧姆接触特性。得益于全封装结构的保护,研究人员成功在BP上进行了栅压可调的多端电磁输运测量。尤为关键的是,同一器件在空气暴露一周前后,其变温霍尔迁移率和载流子密度变化非常微小,充分证明了该封装策略的有效性和器件卓越的空气稳定性。
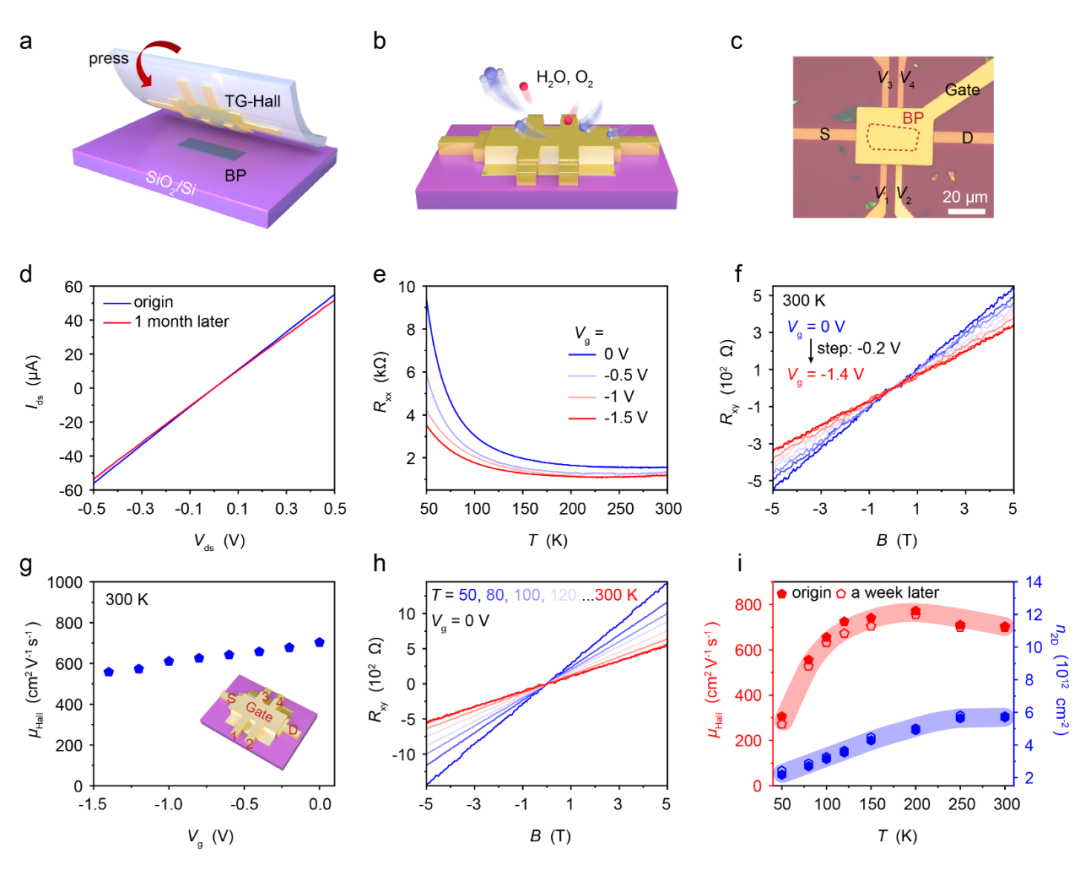
图5. 空气敏感的顶栅黑磷霍尔器件的构筑与封装。
吴金雄团队开发的这种基于云母基底的无牺牲层转移印刷技术,成功解决了晶圆级高质量ALD介电层无损转移的难题,并首次实现了完整顶栅器件堆叠的一步式转移与范德华集成。该方法不仅显著提升了二维晶体管的性能(高开态电流),更重要的是,为研究空气敏感、脆弱二维材料(如黑磷)的本征电学特性提供了强大工具,实现了其多端栅压可调输运测量并展现出卓越的稳定性。该工作不仅极大地丰富了难转移材料的转移印刷方法学,也为解决二维电子学中ALD工艺兼容性和沉积损伤等长期挑战提供了一种可扩展的替代方案,对推动高性能、柔性二维电子器件的发展具有重要意义。
期刊:Nature Communications
题目:Sacrifice-layer-free transfer of wafer-scale atomic-layer-deposited dielectrics and full-device stacks for two-dimensional electronics
作者:Yuyu He, Zunxian Lv, Zhaochao Liu, Mingjian Yang, Wei Ai, Jiabiao Chen, Wanying Chen, Bing Wang, Xuewen Fu, Feng Luo & Jinxiong Wu
接受日期:01 July 2025
原文链接:https://doi.org/10.1038/s41467-025-60864-5